功率电子封装关键材料和结构设计的研究进展(上)
转自:电子与封装
作者:王美玉1,胡伟波1,孙晓冬2,汪青3,于洪宇3
地址:1. 南开大学电子信息与光学工程学院,天津 300350;2. 中科芯集成电路有限公司,江苏 无锡 214072;3 南方科技大学深港微电子学院,深圳 518055
摘要:传统功率电子封装主要以钎料连接和引线键合等二维平面封装技术为主,无法满足第三代半导体器件在高频、高压、高温下的可靠应用。为了解决这一问题,二维平面封装逐渐向三维集成封装发展。对功率电子封装技术中的关键材料和结构设计的研究进展进行了总结和展望。连接材料从锡基钎料逐渐发展为金基钎料、瞬态液相连接材料、烧结银等高导热、耐高温材料,连接技术从引线键合逐渐发展为双面冷却、器件集成和垂直叠层互连等。通过去除引线提高开关性能,集成多种芯片和器件提高功率密度,双面冷却提高散热效率。三维集成封装具有巨大的市场潜力,将成为未来的主要发展趋势之一。
关键词:功率电子封装;封装材料;封装结构;三维封装;烧结银;硅通孔
基金项目:深圳科创委项目(JCYJ20180508161601937)
1
引 言
功率电子器件正在向着高频率、高密度、高功率和高温应用的方向发展[1]。目前,硅(Si)基器件仍占据主导地位,然而由于材料本身的特性,硅基器件的开关频率、工作温度和功率密度等受到了限制。相对于传统硅基器件,第三代半导体如碳化硅(SiC)和氮化镓(GaN)等器件,由于具有更高的击穿电压、更宽的能带隙、更高的热导率和更低的功率损耗,越来越多地应用在如无线通讯、电动汽车、航空航天等高电压、高温度和高频率的应用领域中[2-3]。但与此同时,第三代半导体器件的迅速发展,也对封装技术提出了更为严苛的要求。
封装技术是一种将芯片与承载基板连接固定、引出管脚并将其塑封成整体功率器件或模块的工艺,主要起到电气连接、结构支持和保护、提供散热途径等作用[4]。封装作为模块集成的核心环节,封装材料、工艺和结构直接影响到功率模块的热、电和电磁干扰等特性。目前成熟的封装技术主要是以银胶或锡基钎料等连接材料、引线连接等封装结构为主,耐高温、耐高压性能差,电磁兼容问题突出,无法提供高效的散热途径。近来,烧结银互连材料、三维集成封装结构等由于具有优异的耐高温、高导热性能,可以实现双面散热、大幅降低开关损耗,使得功率模块具有良好的热、电特性和可靠性,获得了越来越多的研究和关注,有望满足第三代半导体器件在高温、高压和高频领域的可靠应用。本文针对功率电子封装材料和结构设计的最新研究进展进行了总结和展望。
2
封装材料
典型的功率模块封装结构如图1所示,由功率芯片、连接材料、键合引线、陶瓷基板、底板、灌封材料、外壳和功率端子等组成[3,5]。各封装材料的热、电、机械和化学性质不同,因此在封装时需要综合考虑各材料的性能进行选择,使整个功率模块达到最优的性能。
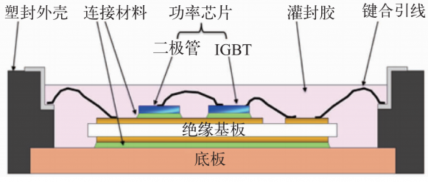
图1 典型的功率模块封装结构[5]
芯片粘接、连接和基板等关键封装材料与技术的发展趋势如图2所示。连接技术从键合引线向带状、铜柱、引线框架和电镀通孔等方向发展,通过去除引线、增大连接面积来提高导热和导电性能。芯片粘接材料从传统锡焊向金基高温钎焊、瞬态液相连接、烧结银和烧结铜等方向发展,大幅提高导热和导电性能,满足高温可靠应用。基板向着增厚陶瓷基板的金属导电导热层发展,从而提高散热效率[5]。
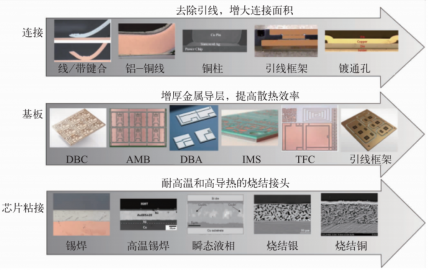
图2 连接、基板和芯片粘接等封装材料和技术的发展趋势[5]
2.1 芯片材料
常用半导体材料的性能参数如表1所示[6-7]。Si因为技术成熟和成本低等特点,目前被广泛应用在各类分立器件和集成电路、电子信息网络工程等领域。相比于Si,GaAs具备禁带宽度大、电子迁移率高的特性,能显著减小射频尺寸、降低功耗,在射频、无线通信和光电子领域的中低功率器件方面得到广泛应用。SiC和GaN具有更大的禁带宽度,在高温工作时不易吸收热辐射能量跳变到导带,并且具有更高的击穿场强,所以宽禁带半导体SiC和GaN比Si更适用于高温和高压场合。SiC的热导率更大,散热能力更好,具有较高的载流子迁移率,能够提供较高的电流密度,并且耐高温、耐高压,因此常被用做功率器件,在电压600 V及以上的高功率领域具有显著优势,在新能源汽车和电力设备等领域应用广泛。GaN的电子迁移率和载流子速度更快,在高压时的导通电阻和寄生参数更小,在高功率射频方向具备明显优势。因为GaN具有高功率密度、低能耗、适合高频率、支持更宽带宽等特点,主要用于5G通信和卫星通讯等微波射频领域、消费电子快充和新能源汽车等电力电子领域以及LED光电子等领域。与SiC类似,目前GaN技术仍在快速发展阶段,成本相对较高。
表1 半导体芯片材料的性能[6]
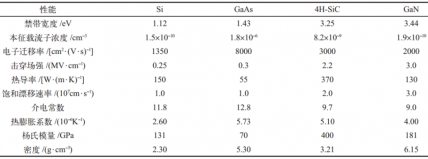
2.2 芯片粘接材料
SnPb合金钎料如Sn63Pb37,由于其优异的性能,如较低的剪切模量,较高的润湿性、延展性、热-机械性能和可靠性,曾被广泛应用于芯片粘接材料。但是SnPb不符合欧盟RoHS无铅标准,并且熔点较低(180 ℃左右),因此需要新的芯片粘接材料来满足封装结构和材料的热膨胀系数(CTE)匹配和耐高温的应用需求。
目前应用最广泛的芯片粘接材料如表2所示[8]。导电银胶主要由树脂基体、导电粒子(主要为银粉)和分散添加剂、助剂等组成,其电导率和热导率相对较低,玻璃化温度约为100~150℃,在高温、高压芯片封装领域受到限制。与SnPb钎料相比,无铅钎料如SnAg或SnAgCu等,Sn含量一般高于90%,熔点相对较高(220 ℃左右),在凝固过程中过冷度较大,容易形成粗大的树枝晶组织及金属间化合物,并呈不均匀分布,使其抗蠕变性减弱。此外,SnAgCu合金有较高的弹性模量,CTE与芯片和基板相差较大,在热循环载荷作用下易发生疲劳破坏导致焊点剥离,降低了焊点可靠性[9]。
表2 芯片粘接材料性能[8]
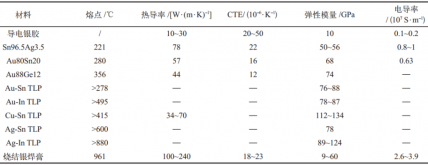
高温芯片粘接材料,如AuSn或AuGe等金基共晶合金钎料,具有较高的熔点(大于280 ℃)、热导率和电导率,并且容易实现无钎剂钎焊。然而,金基钎料中的金含量普遍较高,成本高昂,并且由于组成相具有高脆性,导致加工难度大、成品率低、产品性能差等缺点,严重影响其在功率电子封装领域中的广泛应用[10]。
瞬态液相连接(Transient Liquid Phase Bonding, TLPB)是在熔点较高的被连接母材(如Cu、Au、Ag、Ni)中间加入熔点较低的中间层(如In、Sn),加热使中间层与部分母材熔化并重新凝固,固液之间互相扩散而形成连接的过程。选择合适的材料和工艺,瞬态液相连接可以形成性能优异的接头,如连接强度大于60 MPa[11]。但由于中间层的选择较少、成本较高,以及Au-In等材料的氧化问题,瞬态液相连接在高温芯片互连的应用中受到较大限制。
烧结银互连也称为低温连接技术,是基于纳米银或微米银颗粒的固相原子扩散形成烧结连接。烧结银工艺温度低(200~300℃),熔点高(961 ℃),具有如热导率高、抗温度循环和功率循环可靠性高等众多优点,成为高温芯片互连的优先选择,得到了越来越广泛的研究和应用[12]。但是烧结银也有一些缺点,如成本较高,纳米银颗粒易低温团聚,微米银焊膏需要加压烧结,工艺复杂,并且需要芯片和基板表面进行Ni/Au或Ni/Ag等金属镀层处理,以及存在银容易发生电化学迁移等问题。相比于纳米银焊膏,纳米铜焊膏由于成本较低,无电化学迁移的可靠性风险,最近开始引起关注[13]。但纳米铜颗粒易氧化,需要在惰性气氛中烧结,增加了工艺复杂度和设备成本,具有一定的应用局限性。
2.3 塑封材料
塑封材料的主要功能是电气绝缘和环境隔离,起到防潮、防盐雾、防霉、防尘、防碰撞和防振等防护作用,避免遭受环境的腐蚀与破坏,从而保证电子组件的电气性能,甚至提高高压功率模块的电压等级,避免电极放电,最终提高电子产品的可靠性[14]。塑封材料的种类和性能如表3所示,塑封材料可分为敷形涂料(Conformal Coatings)、底部填充胶(Underfills)、模塑料(Molding Compounds)、灌封胶(Potting Compounds)和顶部包封胶(Glob Tops)[14]。
表3 塑封材料的种类和性能[14]

敷形涂料是一种常用于印制线路表面防护的有机涂料,需要与基板和组件有良好的连接性能。一般选择具有低吸水率、高介电强度、匹配的CTE、低弹性模量的材料,如可在小于120 ℃低温使用的丙烯酸,在小于165 ℃中低温使用的聚氨酯,在小于200 ℃中温使用的环氧树脂,以及可在大于250 ℃高温使用的硅树脂、聚对二甲苯、苯并环丁烯和聚酰亚胺等。
底部填充胶和模塑料如图3所示,其作用除了可以与周围环境隔离和降低电场应力,还可以通过降低或重新分布由CTE不匹配带来的热-机械应力来提高封装产品的可靠性[14]。因此,应该尽可能选择与封装结构内各组件CTE相匹配的材料,如CTE为(20~30)×10-6/K和小于20×10-6/K的硬质材料分别作为底部填充胶和模塑料来分别降低来自焊锡球以及包括焊锡球在内的整个封装结构的热应力。目前,最常用的底部填充胶和模塑料为二氧化硅填充的环氧树脂。
灌封胶和顶部包封胶除了提高抗电场击穿的电压等级和避免周围环境的腐蚀与破坏等,还对封装结构起到一定的机械支撑作用。目前最常用的灌封胶和顶部包封胶材料为可在小于165 ℃低温应用的聚氨酯,在小于200 ℃中温应用的环氧树脂,以及在小于300 ℃高温应用的硅橡胶或凝胶等。其中硅橡胶或凝胶等软质材料由于具有较低的硬度和模量、较高的塑性和弹性,对芯片、键合线等封装组件的应力影响较小,得到了最广泛的应用。但硅橡胶和凝胶等软质材料的机械支撑和保护性能较差。为了抵抗外部冲击,可以选择树脂等硬质材料。但是树脂通常具有较高的模量,需要选择CTE匹配的材料,避免对整个封装结构带来过大的热-机械应力。
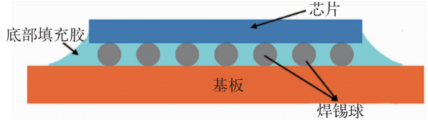
(a)底部填充胶
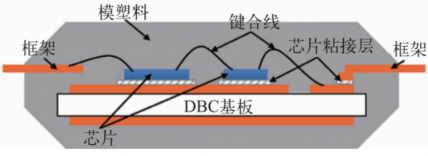
(b)模塑料示意图
图3 功率电子封装结构中的底部填充胶和模塑料示意图[14]
2.4 基板与底板材料
一般来说,基板是一个“金属导电层-绝缘层-金属导电层”的三明治结构,上下两层金属导电层分别用于芯片和底板的互连。根据制造工艺,基板可分为直接覆铜基板(Direct Bonded Copper,DBC)、直接电镀基板(Direct Printed Copper,DPC)、直接覆铝基板(Direct Bonded Aluminum,DBA)、活性金属钎焊基板(Active Metal Brazing,AMB)、绝缘金属基板(Insulated Metal Substrate,IMS)以及厚膜印刷基板(Thick-film Printed Copper,TPC)等。
DBC基板是在铜膜上采用薄氧化铜与陶瓷形成共晶连接,其兼具优异的性能和相对较低的成本,在功率电子封装中得到了最广泛的应用。然而,陶瓷连接界面处的氧化铜薄膜容易分层,造成DBC基板的抗温度循环可靠性较低。AMB基板是采用活性金属钎焊将金属和陶瓷连接在一起,可以消除氧化层,提高可靠性。DBA基板是采用AlSi钎焊来连接铝板和陶瓷,相对于DBC的铜层来说,铝层的硬度更低,可以承受更高的热-机械应力,提高可靠性[15]。但铝的热导率比铜低,DBA基板的散热性能不如DBC基板。IMS基板包括一层高导热的绝缘树脂、一层铜底板和厚铜膜。与DBC相比,IMB制造工艺简单、热处理温度低、成本低、可靠性高。TPC基板是在陶瓷上丝网印刷一层铜膏,通过在850~950 ℃高温烧结,形成金属膜与陶瓷的高强度连接,温度循环可靠性较高,可与集成电路芯片和无源器件高度集成来形成混合模块。最近也出现了基于厚引线框架-薄绝缘层的基板,简化了多层基板结构,提高了散热效率[5]。
综合考虑热导率和CTE等,Al2O3、Si3N4、AlN和BeO是基板中最常用的陶瓷材料,其性能比较见表4[8,16]。BeO具有最高的热导率,但是制备过程中的微尘对人体有害,导致其应用受到很大限制。Al2O3是最经济的选择,但是机械强度适中,导热性能相对较差。AlN的热导率比Al2O3更高,CTE与芯片更匹配。Si3N4具有更高的温度循环可靠性,但成本相对较高[17]。相对而言,Al-AlN和Cu-Si3N4的组合可靠性更高,其原因是前者铝材料较软,弹性模量较低,容易变形,可以减缓热应力对陶瓷造成的损伤;后者Si3N4的抗弯强度和断裂韧性较大,可以抵抗铜带来的热应力。
表4 基板中的陶瓷材料性能[8]

最常用的底板材料为Cu,为了降低CTE和保证高热导率,金属复合材料如AlSiC、W-Cu、Mo-Cu、以及Cu-Mo-Cu也得到广泛应用,其性能参数见表5[8]。底板一般会做镀镍处理,可以防止高温下铜原子的迁移和氧化,提高铜底板的强度和变形抗力。
表5 底板材料性能[8]
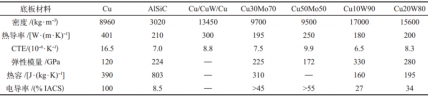
免责申明:本文内容转自:电子与封装,作者:王美玉,胡伟波,孙晓冬,汪青,于洪宇。文字、素材、图片版权等内容属于原作者,本站转载内容仅供大家分享学习。如果侵害了原著作人的合法权益,请及时与我们联系,我们会安排删除相关内容。本文内容为原作者观点,并不代表我们赞同其观点和(或)对其真实性负责。
AMB、AMB载板、活性钎焊、活性金属钎焊、陶瓷覆铜板、陶瓷基板、DBC、高可靠性基板、SiC芯片载板、AMB陶瓷基板、AMB陶瓷覆铜板、DBC基板、DBC陶瓷基板、芯片载板、IC载板、碳化硅IC载板、碳化硅载板、半导体碳化硅IC载板、第三代功率半导体碳化硅IC载板、第三代功率半导体载板、第三代功率半导体基板、银铜钛焊膏、银铜钛焊片、AgCuTi活性焊膏、AgCuTi、厚铜陶瓷基板、双面厚铜陶瓷板、银焊膏、银胶、银浆、烧结银、低温银胶、银烧结、纳米银锡膏、纳米银、纳米银膏、锡锑Sn90Sb10焊料片、锡锑焊片、Sn90Sb10 Solder Preforms
威尼斯欢乐娱人城3328是先进半导体封装连接材料制造商,我们可根据客户的要求定制专业配比的金、银、铜、锡、铟等焊料合金,加工成预成型焊片,更多资讯请看www.xianyichina.com,或关注微信公众号“威尼斯欢乐娱人城3328”。








